硅基綠色氮化銦鎵 LED 內部量子效率大幅提升的新突破
來源:
時間:2024-08-12 19:49:25
在半導體領域,硅基綠色氮化銦鎵 LED 的發展一直是研究的熱點。此次研究人員取得的重大突破,為這一領域帶來了新的希望。
近期,研究人員發布報告稱,僅憑借單個氮化鋁(ALGaN)緩沖層,成功將硅基綠色氮化銦鎵(InGaN)發光二極管(LED)的內部量子效率(IQE)提升了 78% [Ayu-Dai 等人,Appl. Phys. Lett.,v125,p022102024]。雖然未具體給出該器件的電致發光結果,但如此顯著的 IQE 提升頗為引人注目,因其有望推動更低功耗綠色和紅色 Micro-LED 的制造及商業化進程。
眾所周知,在硅基板上直接制造藍色 LED 存在諸多難題,通常需要運用 AlN 成核層以及一些分級 AlGaN 緩沖層來銜接硅與 GaN 之間極大的熱膨脹失配。然而即便如此,當溫度從工藝所需的高溫冷卻至室溫時,在上述緩沖結構上生長的 GaN 層仍會殘留部分應力,這一應力殘留最終會阻礙銦元素摻入后續用于發射可見光的 InGaN 層。另一方面,對于更長的綠色和紅色光來說,起發光作用的 InGaN 層所需的銦元素比藍色光更多。
在此情形下,來自中國科學技術大學、蘇州納米技術與納米離子研究所、廣東半導體微納制造技術研究所和蘇州樂金光電技術有限公司的合作團隊給出了全新的解決方案。他們表示:“我們的研究成果表明,在 GaN-on-Si 器件制造過程中,恰當的應力管理對于基于硅基晶圓制造 InGaN 長波長 Micro-LED 乃至全彩色微型顯示器極為關鍵。
除硅之外,市場上存在眾多可用于制造 LED 芯片的基板材料,但這些基板往往尺寸較小且價格高昂,不利于進行批量低成本生產。相較而言,硅基板優勢明顯,不僅直徑尺寸較大,能夠實現低成本的大規模生產,還能更好地與驅動背板實現集成,因為當前絕大多數驅動系統均基于硅電子技術實現。硅基驅動和發光元件的單片集成能夠進一步降低電子系統的復雜性和成本。
如下圖 1 所示,本研究所用的外延材料通過金屬有機化學氣相沉積(MOCVD)技術在硅基板上生長。研究人員對比處理了兩種不同設計的樣品,其一在 AlN 上采用傳統的階梯式 AlGaN 緩沖層,另一個則在 n-GaN 接觸/緩沖/模板層之前僅運用一個 AlN 緩沖層。
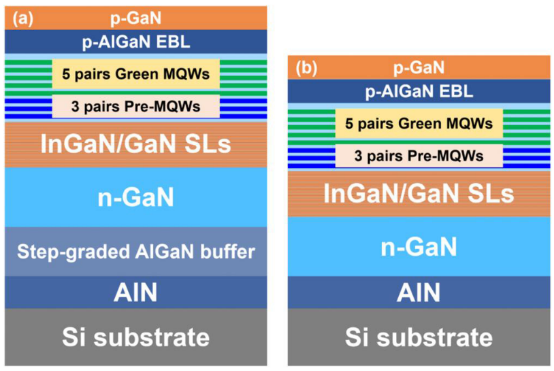
圖 1. 用于性能對比的、基于 InGaN 的綠色硅基 LED 方案:(a)樣品 A 采用 Al 成分分級的 AlN/AlGaN 多層緩沖層,(b)樣品 B 僅采用一個簡單的 AlN 單層緩沖層
據研究人員介紹:“本研究中用于制造 GaN 樣品 A 的 Al 成分分級 AlN/AlGaN 多層緩沖層屬于市售材料,已用于大規模生產 GaN-on-Si 藍色 LED,并展現出高效率和高可靠性。”
研究人員對所制造的樣品進行了相關測試,X 射線分析顯示,樣品 B 中 2μm GaN 的螺紋位錯(TD)密度高于樣品 A:分別為 2.5×109/cm2 和 9.0×108/cm2。隨后,研究人員將這兩個樣品一同放入 MOCVD 室中,并生長出更多的綠色 InGaN LED 層。
這里生長的 LED 疊層結構由 160nm In0.05Ga0.95N/GaN 超晶格(SL)、多量子阱(MQW)、20nm 電子阻擋層和 35nm p-GaN 接觸層共同構成。其中,MQW 發光區又由三個 2nm 發藍色光的 In0.12Ga0.88N/GaN 預阱和五個 2.5nm 發綠色光的 In0.25Ga0.75N/GaN 阱組成,這兩個量子阱又被 10nm 的 GaN 勢壘隔開。
如圖 2 所示,微型光致發光(PL)分析結果表明,樣品 B 的發光模式比樣品 A 更為均勻。此外,與樣品 A 不同,樣品 B 的發光模式不存在明顯可見的暗點。對此,研究人員評論道:“微型光致發光圖像中的暗點,通常代表由 InGaN MQW 熱降解引起的非輻射復合中心。”

圖 2. 樣品 A(a)、(c)和(e)以及樣品 B(b)、(d)和(f)的 InGaN MQW 的微型光致發光圖像、俯視 SEM 圖像和全色 CL 圖像對比
運用掃描電子顯微鏡(SEM)和陰極發光(CL)進一步檢查發現,樣品 A 和 B 的 V 位密度分別為 7.0×108/cm2 和 2.0×109/cm2,這一數值與螺紋位錯值相符。實際上,V 形位通常在螺紋位錯上形成。
該研究團隊指出:“理論和實驗結果已經證實,側壁具有較薄 QW 的 V 型位能夠產生勢壘并屏蔽螺紋位錯的影響,這有助于空穴注入并增強輻射復合,我們認為這是提升 InGaN 基 LED 發光效率的有效途徑。”
也就是說,較高的螺紋位錯密度未必是壞事。上述 CL 圖像顯示,樣品 A 存在黑斑簇,在光學顯微鏡水平上呈現為黑斑,而樣品 B 的 CL 圖像上斑點分布更均勻,具有更良好的光學形態。
另一方面,PL 光譜顯示,樣品 B 相較于樣品 A 具有更長的 40nm 紅移峰。拉曼光譜還表明,與樣品 A 不同,樣品 B 幾乎沒有應變。樣品 A 中的壓應力估計達到 0.37Gpa,而樣品 B 的應力約為 0GPa。
研究人員表示:“拉曼光譜的測試結果表明,GaN 樣品 B 中使用的 AlN 單層緩沖層能夠有效地釋放后續 GaN 各層的殘余壓應力,這一方案有望通過減少 GaN 和 InGaN 之間的失配應變,增加 InGaN MQW 的銦元素摻入。”
另外,高角度環形暗場(HAADF)掃描透射電子顯微鏡(STEM)圖像還表明,由于殘余應變的存在,樣品 A 中的 MQW 結構相較于 B 有所退化(如圖 3 所示)。
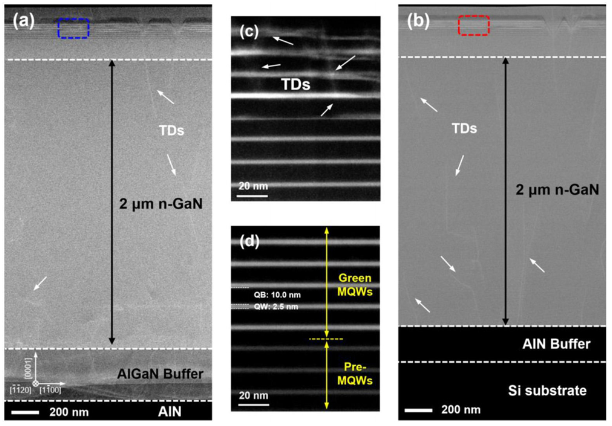
圖 3:(a)樣品 a 和(b)樣品 b 的 InGaN 基 LED 材料的橫截面 HAADF-STEM 圖像,以及(c)樣品 a、(d)樣品 b 用藍色和紅色矩形標記的有源 MQW 區域的放大圖像。
通過對比 5K 和 300K 下的 PL 發光強度,研究人員評估出樣品 A 和 B 的室溫內部量子效率(IQE)分別為 33%和 78%。
此外,為更深入理解這一差異機制,研究人員還開展了時間分辨的 PL 研究,他們提取了快(τ1)和慢(τ2)壽命。根據測試結果,研究人員認為這反映了載流子從弱局域態到強局域態的轉移,其中緩慢的τ2衰變與局域態中的載流子復合有關。
綜上所述,這一研究成果為硅基綠色氮化銦鎵 LED 的發展開辟了新的道路。相信在未來,這一技術將在更低功耗綠色和紅色 Micro-LED 的制造中發揮重要作用,為相關產業帶來更多的創新和發展機遇。
近期,研究人員發布報告稱,僅憑借單個氮化鋁(ALGaN)緩沖層,成功將硅基綠色氮化銦鎵(InGaN)發光二極管(LED)的內部量子效率(IQE)提升了 78% [Ayu-Dai 等人,Appl. Phys. Lett.,v125,p022102024]。雖然未具體給出該器件的電致發光結果,但如此顯著的 IQE 提升頗為引人注目,因其有望推動更低功耗綠色和紅色 Micro-LED 的制造及商業化進程。
眾所周知,在硅基板上直接制造藍色 LED 存在諸多難題,通常需要運用 AlN 成核層以及一些分級 AlGaN 緩沖層來銜接硅與 GaN 之間極大的熱膨脹失配。然而即便如此,當溫度從工藝所需的高溫冷卻至室溫時,在上述緩沖結構上生長的 GaN 層仍會殘留部分應力,這一應力殘留最終會阻礙銦元素摻入后續用于發射可見光的 InGaN 層。另一方面,對于更長的綠色和紅色光來說,起發光作用的 InGaN 層所需的銦元素比藍色光更多。
在此情形下,來自中國科學技術大學、蘇州納米技術與納米離子研究所、廣東半導體微納制造技術研究所和蘇州樂金光電技術有限公司的合作團隊給出了全新的解決方案。他們表示:“我們的研究成果表明,在 GaN-on-Si 器件制造過程中,恰當的應力管理對于基于硅基晶圓制造 InGaN 長波長 Micro-LED 乃至全彩色微型顯示器極為關鍵。
除硅之外,市場上存在眾多可用于制造 LED 芯片的基板材料,但這些基板往往尺寸較小且價格高昂,不利于進行批量低成本生產。相較而言,硅基板優勢明顯,不僅直徑尺寸較大,能夠實現低成本的大規模生產,還能更好地與驅動背板實現集成,因為當前絕大多數驅動系統均基于硅電子技術實現。硅基驅動和發光元件的單片集成能夠進一步降低電子系統的復雜性和成本。
如下圖 1 所示,本研究所用的外延材料通過金屬有機化學氣相沉積(MOCVD)技術在硅基板上生長。研究人員對比處理了兩種不同設計的樣品,其一在 AlN 上采用傳統的階梯式 AlGaN 緩沖層,另一個則在 n-GaN 接觸/緩沖/模板層之前僅運用一個 AlN 緩沖層。
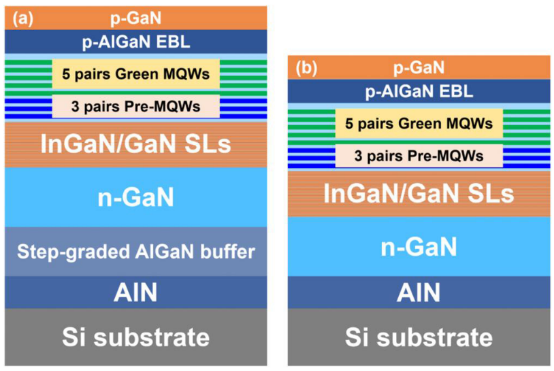
圖 1. 用于性能對比的、基于 InGaN 的綠色硅基 LED 方案:(a)樣品 A 采用 Al 成分分級的 AlN/AlGaN 多層緩沖層,(b)樣品 B 僅采用一個簡單的 AlN 單層緩沖層
據研究人員介紹:“本研究中用于制造 GaN 樣品 A 的 Al 成分分級 AlN/AlGaN 多層緩沖層屬于市售材料,已用于大規模生產 GaN-on-Si 藍色 LED,并展現出高效率和高可靠性。”
研究人員對所制造的樣品進行了相關測試,X 射線分析顯示,樣品 B 中 2μm GaN 的螺紋位錯(TD)密度高于樣品 A:分別為 2.5×109/cm2 和 9.0×108/cm2。隨后,研究人員將這兩個樣品一同放入 MOCVD 室中,并生長出更多的綠色 InGaN LED 層。
這里生長的 LED 疊層結構由 160nm In0.05Ga0.95N/GaN 超晶格(SL)、多量子阱(MQW)、20nm 電子阻擋層和 35nm p-GaN 接觸層共同構成。其中,MQW 發光區又由三個 2nm 發藍色光的 In0.12Ga0.88N/GaN 預阱和五個 2.5nm 發綠色光的 In0.25Ga0.75N/GaN 阱組成,這兩個量子阱又被 10nm 的 GaN 勢壘隔開。
如圖 2 所示,微型光致發光(PL)分析結果表明,樣品 B 的發光模式比樣品 A 更為均勻。此外,與樣品 A 不同,樣品 B 的發光模式不存在明顯可見的暗點。對此,研究人員評論道:“微型光致發光圖像中的暗點,通常代表由 InGaN MQW 熱降解引起的非輻射復合中心。”

圖 2. 樣品 A(a)、(c)和(e)以及樣品 B(b)、(d)和(f)的 InGaN MQW 的微型光致發光圖像、俯視 SEM 圖像和全色 CL 圖像對比
運用掃描電子顯微鏡(SEM)和陰極發光(CL)進一步檢查發現,樣品 A 和 B 的 V 位密度分別為 7.0×108/cm2 和 2.0×109/cm2,這一數值與螺紋位錯值相符。實際上,V 形位通常在螺紋位錯上形成。
該研究團隊指出:“理論和實驗結果已經證實,側壁具有較薄 QW 的 V 型位能夠產生勢壘并屏蔽螺紋位錯的影響,這有助于空穴注入并增強輻射復合,我們認為這是提升 InGaN 基 LED 發光效率的有效途徑。”
也就是說,較高的螺紋位錯密度未必是壞事。上述 CL 圖像顯示,樣品 A 存在黑斑簇,在光學顯微鏡水平上呈現為黑斑,而樣品 B 的 CL 圖像上斑點分布更均勻,具有更良好的光學形態。
另一方面,PL 光譜顯示,樣品 B 相較于樣品 A 具有更長的 40nm 紅移峰。拉曼光譜還表明,與樣品 A 不同,樣品 B 幾乎沒有應變。樣品 A 中的壓應力估計達到 0.37Gpa,而樣品 B 的應力約為 0GPa。
研究人員表示:“拉曼光譜的測試結果表明,GaN 樣品 B 中使用的 AlN 單層緩沖層能夠有效地釋放后續 GaN 各層的殘余壓應力,這一方案有望通過減少 GaN 和 InGaN 之間的失配應變,增加 InGaN MQW 的銦元素摻入。”
另外,高角度環形暗場(HAADF)掃描透射電子顯微鏡(STEM)圖像還表明,由于殘余應變的存在,樣品 A 中的 MQW 結構相較于 B 有所退化(如圖 3 所示)。
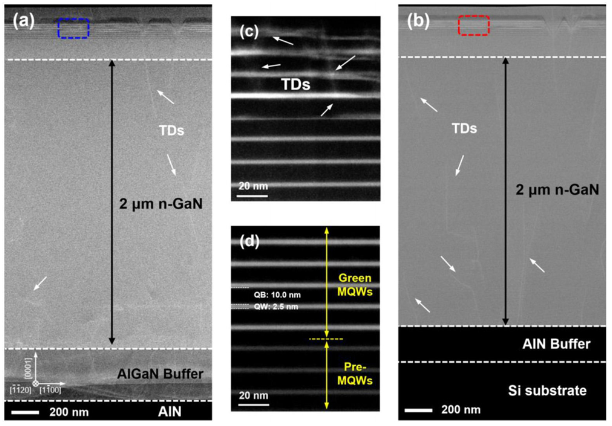
圖 3:(a)樣品 a 和(b)樣品 b 的 InGaN 基 LED 材料的橫截面 HAADF-STEM 圖像,以及(c)樣品 a、(d)樣品 b 用藍色和紅色矩形標記的有源 MQW 區域的放大圖像。
通過對比 5K 和 300K 下的 PL 發光強度,研究人員評估出樣品 A 和 B 的室溫內部量子效率(IQE)分別為 33%和 78%。
此外,為更深入理解這一差異機制,研究人員還開展了時間分辨的 PL 研究,他們提取了快(τ1)和慢(τ2)壽命。根據測試結果,研究人員認為這反映了載流子從弱局域態到強局域態的轉移,其中緩慢的τ2衰變與局域態中的載流子復合有關。
綜上所述,這一研究成果為硅基綠色氮化銦鎵 LED 的發展開辟了新的道路。相信在未來,這一技術將在更低功耗綠色和紅色 Micro-LED 的制造中發揮重要作用,為相關產業帶來更多的創新和發展機遇。
 客服
客服
