LED芯片封裝工藝流程及需要哪些材料?
在LED封裝中有機硅,即有機硅化合物, 指含有 Si-O 鍵、且至少有一個有機基是直接與硅原子相連的化合物。有機硅產 品的關鍵性能包含優異的耐溫性,即高溫、低溫環境下的結構穩定性;良好的耐 候性,即大氣環境中不易被紫外線及臭氧所分解;穩定的電絕緣性能,即產品介 電損耗小、耐高壓、具有優異的表面電阻系數等。
環氧樹脂指分子中含有兩個或 兩個以上環氧基的有機高分子化合物,具有力學性能高、內聚力強、分子結構致 密,粘接性能優異,固化收縮率小、內應力小,絕緣、防腐性及耐熱性優良等特 點。上述有機硅及環氧樹脂材料關鍵性能滿足電子元器件產品粘接、包封中的重 要性能需求,對封裝后電子器件的可靠性、使用壽命等有著重要作用,促使了有 機硅及環氧樹脂材料在電子電器封裝領域的廣泛應用及持續發展。

LED 芯片封裝除需要滿足芯片封裝高精密度和器件可靠性要求外,還需保 證光學性能的實現,因此封裝工藝要求極為嚴格。作為 LED 芯片封裝工藝中的核心材料之一,在起到粘接、固定、包封等基本功 能的基礎上,還需具備折射、透光、導電、導熱、水汽阻隔、減震抗沖等各類復 合功能,產品性能及質量穩定性對于 LED 器件、模組及終端產品的光效、可靠 性、壽命均有著重要的影響,進而決定了其較高的產品附加值。
LED 芯片封裝用電子膠粘劑主要產品包含高折射率有機硅封裝膠、Mini LED 有機硅封裝膠、有機硅固晶膠、電子環氧封裝膠、LED 環氧模塑料、導電 銀膠等,已廣泛應用于新型顯示、半導體通用照明、半導體專用照明、半導體器 件封裝、航空航天等領域。主要應用于 LED 芯片封裝過程中的包封、固晶環節。系列產品可適用于倒裝結構、正裝 結構、垂直結構等不同種類芯片及 SMD、POB、COB 及 CSP 等多種新型 LED 芯片封裝方式,產品具體應用場景示例如下:
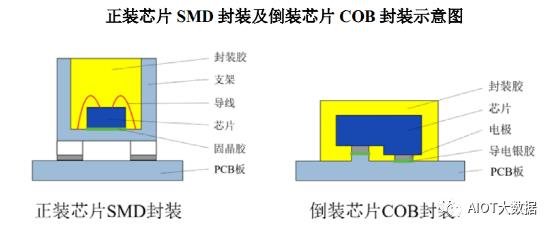
主要性能需求 電子封裝材料的應用性能體系較為復雜,主要包含光學性能、可靠性、工藝 操作性及穩定性四大類別。在對某一特定性能進行優化的過程中,配方中聚合物 成分之間的反應可能對其他性能指標產生不利影響。因此,各類性能之間的平衡 兼顧及共同優化具有較高的技術門檻。

隨著新型顯示、半導體通用照明、半導體專用照明等下游應用領域持續發展, LED 芯片封裝工藝快速演進,形成了多種封裝工藝并存的市場格局。輕薄化、 微間距、高光效等封裝技術發展趨勢對電子封裝材料的性能要求持續提升。

同時隨著封裝形式、芯片結構、基材種類不斷豐富,下游客戶封裝工藝技術路線不斷 更新,對電子封裝材料廠商產品儲備豐富度提出更高要求。電子封裝材料技術難點在于需將下游客戶對于電子封裝材料的應用需求從工藝和性能兩方面轉 化為產品的技術指標要求,并通過核心成分設計及自主合成、配方開發優化、關鍵工藝流程把控,實現技術指標調整及平衡。
 客服
客服
